EMMI(Emission Microscope Multilayer Inspection), PHEMOS, THERMOS, OBIRCH
EMMI(Emission Microscope Multilayer Inspection)이란 여기된 Electron과 Hole이 재결합(recombination) 할 때 발생하는 광자(photon)을 인식하여 leakage current(누설전류) 등을 통해 반도체의 고장을 분석할 수 있는 분석기법이다.
반도체 내부에서 전기가 흐르기 위해서 반도체 물질 내부의 전자가 바닥상태에서 들뜬 상태로 여기되는 현상이 발생하며, 이와 같은 현상에 의해 반도체 특성을 가지고 전기가 흐르게 되는 것이다. 이를 반대로 하면 전기가 흐를 수 없는 고장, 혹은 전류가 흐르지 않아야 할 곳에 전기가 흐르는 현상이 발생할 경우 여기된 전자가 다시 정공(hole)과 결합되거나 그 외에 여러 가지 이유로 빛이 발생하는 현상이 일어나는 데 이를 이용하여 반도체 등의 고장을 분석하는 기법을 EMMI라고 할 수 있다.
이러한 현상으로 다음과 같은 것들을 들을 수 있다.
1. 핫 캐리어 발광
반도체 소자 내부 FET 에 있는 강한 전계에 의해 가속된 전자나 홀이 에너지를 잃는 과정에서 핫 캐리어 발광이라는 현상이 발생한다. 발광 메커니즘에는 여러 가지 가설이 있으나 주로 서브밴드(원자 껍질 구조에서 주밴드가 아닌 보조밴드를 의미) 사이의 천이 혹은 여러 가지 복합작용 등이 원인이라고 추측하고 있다. 빛의 발생량은 전계강도에 강하게 의존하고 있으므로 초미세공정이 발달됨과 동시에 발광량이 증가하는 경향을 보인다. 발광 파장 영역은, 에너지 공급원이 구동전압에 의한 전계와 열운동 에너지로 되므로 구동전압이 저하되면 발생하는 광자의 에너지도 낮아져 장파장 영역으로 천이될 수 있다.
이 발광 현상은 주로 다음과 같은 상태에서 관찰될 수 있다.
가. OFF 상태의 누설 전류 이상
나. GATE 전압의 이상(전방 배선 등에서 유래)에 의한 포화 영역 동작
다. 스위칭 시의 과도전류, 관통전류
라. OFF 상태 시의 누설 전류
2. 전자·홀의 재결합
반도체 내에서 전자와 홀이 재결합할 때, 밴드갭에 해당하는 에너지의 파장의 크기만큼 발광할 수 있다. 단 Si 등과 같이 주밴드갭 외에 불순물에 의해 다양한 에너지준위를 형성한 간접 천이 반도체의 경우는 효율이 낮을 수도 있다. 단, 래치업 해석 등 높은 전류에 의해 발생되는 불량 분석에는 중요한 역할을 할 수도 있다.
3. 관통전류
산화물 유전체 등으로 형성된 절연막의 절연이 파괴되어 관통전류가 흐르면, 전류에 의한 발열과 발광 현상이 발생한다. 단, 최근에는 성막 기술이 향상되어 잘 발견되지 않는 고장이다.
4. 열 흡수
반도체에 빛을 조사할 때, 광전효과가 발생하지 않고 열만 흡수될 수도 있다.
위와 같은 고장을 일으키는 원인으로 Source to Drain Leakage, Oxidation Breakdown, ESD Failure, Hot Carrier 발생, Latch-Up 현상 등이 있을 수 있다.
위와 같은 고장을 분석하는 기법으로 PHEMOS, THERMOS, ORBICH 등을 들 수 있다.
PHEMOS (Photon Emission Microscope)
PHEMOS는 wafer 및 package 상태의 device에 전기적 신호를 인가한 후 불량 위치에서 발생하는 미약한 빛(Photon)을 검출하는 시스템으로, device의 누설 전류 및 short 불량 위치 등을 검출할 수 있다. PHEMOS로 검출 가능한 대표적인 불량으로는 Source to Drain leakage, Gate leakage, oxidation breakdown, ESD failure, hot carrier 발생, latch up 등이 있다.
PHEMOS에서는 보통 InGaAs camera를 사용하며, 외부 빛을 차단한 암실에서, InGaAs나 Laser을 통해 획득한 Pattern image와 Emission image를 중첩시켜서 정확한 불량 위치를 확인한다.

그림. PHEMOS 원리, 이미지, 장비 (출처 : www.hamamatsu.com)
THEMOS (Thermal Emission Microscope)
THEMOS는 device에 전기적 신호를 인가한 후 불량 위치에서 발생하는 열을 검출하는 시스템으로, device의 누설 전류 및 short 불량 위치를 검출할 때 많이 사용된다. THERMOS로 검출가능한 대표적인 불량으로는 Metal melting, Bridge short, Oxide crack, Metal particle, Migration, Contact spike 등이 있다. THERMOS에서는 InSb camera를 주로 사용하며, PHEMOS와 다르게 THERMOS는 외부 빛이 차단되지 않은 자연광에 노출된 상태에서도 진행할 수 있다.
OBIRCH (Optical Beam Induced Resistance Change)
OBIRCH는 Laser Heating에 의한 열기전력 발생지점을 찾는 것으로, 저항의 변화를 Image로 나타내는 것이다. InGaAs와 동일 대역 Laser를 사용하며 주로 Leakage 성 불량을 검출해 낸다. 감도가 매우 우수하며 A 수준의 미세한 Leakage 성 불량을 검출하는데 탁월하며 Normal spot이 없어서 Hot spot에 대한 높은 신뢰도를 가진다. 높은 감도로 인해 주변 환경으로 인한 Noise에 약하다는 단점이 있다. 분석 중 Laser 세기에 의해 damage 받을 수 있다.
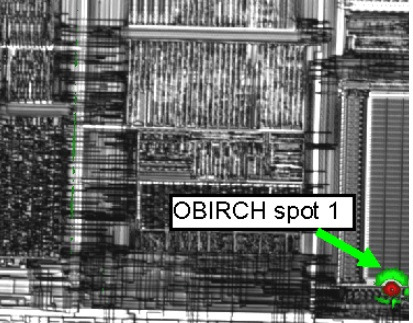
그림. OBIRCH 이미지 예시(출처 : www.semantischolar.org)